您當前的位置:檢測資訊 > 檢測案例
嘉峪檢測網 2022-03-11 23:29
主板BGA開裂失效分析
背景:
客戶生產的主板上的BGA在第二次過爐后出現開裂現象,斷裂發生在組件側。故委托實驗室進行分析,以便找到失效原因。
分析結果:
1.熒光劑浸泡+冷拔+斷口分析結果,排除“金脆”引發BGA開裂的可能性。
2.動態翹曲度測試結果表明,PCB四連板在加熱過程中變形明顯,呈現中間下凹、左右兩邊上凸的形態。且其在冷卻完成后翹曲最嚴重。
3.開裂焊點統計結果顯示,開裂多發生在未植球的空白區域附近,且部分區域的焊點開裂更嚴重,與翹曲有一定的關聯性。綜合各測試結果,推測離PCB中間區域越近的BGA錫球,越容易產生開裂。
4.原物料切片后發現部分錫球存在原始微裂紋。推測有原始微裂紋的錫球在焊接過程中,PCB板翹曲變形,使得裂紋擴張,造成錫球開裂。
失效癥狀:
BGA開裂
根本原因:
BGA原物料具有原始微裂紋,PCB在焊接過程翹曲變形,使裂紋擴張,造成開裂。
改善建議:
1.管控BGA在焊接過程中的翹曲。
2.嚴格管控BGA的來料品質。

客戶生產的主板上的BGA在第二次過爐后出現開裂現象,斷裂發生在組件側。
PCB表面處理為化鎳浸金。

對不良BGA進行切片,在第4排錫球(Row4)發現有開裂,開裂發生在BGA側,裂紋沿著IMC擴展,且斷口焊錫有重熔現象。推斷開裂和翹曲有關,可能發生在第一次過爐的降溫階段或者第二次過爐的升溫階段。
此外在斷口部分區域發現有Au元素富集現象,需對“金脆”現象進行排除。

冷拔+斷口分析
將主板浸泡在濃度為3%的熒光劑水溶液,抽真空,干燥后,對BGA位置進行冷拔。在紫外光下觀察焊點發光情況,確認開裂狀況。

對焊點開裂區域進行檢查,未發現明顯的Au元素富集,排除“金脆”引發BGA開裂的可能性。
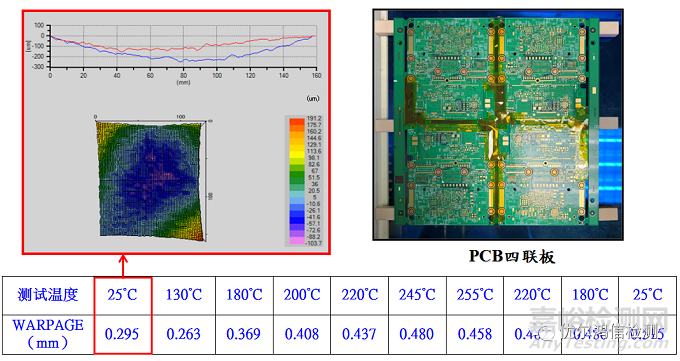
對PCB四聯板進行動態翹曲度測試,結果如上所示。PCB在室溫即存在一定扭曲,中間下凹、左上角和右下角有一定凸起。

PCB四聯板在升溫過程中會逐漸軟化變形,呈現中間下凹、左右兩邊上凸的形態,一直到降溫結束,這種形態都沒有明顯改變。在最后冷卻到室溫時,出現了一個翹曲的極值。所以此PCB在第一次過爐后,冷卻完畢會出現一個最大翹曲。

對僅B面打件的小板進行動態翹曲度測試,結果如上所示。未發現明顯的翹曲變化。單獨的小板翹曲并不嚴重,小板上塑料件的存在也并未加劇PCB的翹曲。

對不良品的BGA錫球高度進行統計。結果顯示BGA錫球呈現中間高兩邊低的現象,錫球高度受到了翹曲的影響。
BGA左側的錫球,裂紋多出現在左邊;右側的錫球,裂紋多出現在右邊。與翹曲有一定的關聯性。

對不良BGA錫球開裂狀況進行統計。結果表明,開裂多發生在未植球的空白區域附近,且部分區域(紅框位置)的焊點開裂更嚴重。

PCB四聯板在加熱過程中,中間區域(紅圈位置)會出現軟化下凹,變形明顯。
綜上推測:離PCB中間區域越近的BGA錫球,越容易產生開裂。

對1pcsBGA原物料進行切片,發現部分錫球的邊角已經有細小缺口或微裂紋。第一排25個錫球里有三個球發現微裂紋或小缺口。
小缺口區域有IMC生成,推測其產生原因可能和植球時的邊角退潤濕有關。
綜上,推測有原始微裂紋的錫球在焊接過程中,PCB板翹曲變形,使得裂紋擴張,造成錫球開裂。
結論
1.主板的BGA 開裂發生在組件側IMC層且斷口有二次重熔現象。斷口部分區域有Au元素富集現象。
2.熒光劑浸泡+冷拔+斷口分析結果,排除“金脆”引發BGA開裂的可能性。
3.動態翹曲度測試結果表明,PCB四連板在加熱過程中變形明顯,呈現中間下凹、左右兩邊上凸的形態。且其在冷卻完成后(255℃降至25℃)翹曲最嚴重。
4.開裂焊點統計結果顯示,開裂多發生在未植球的空白區域附近,且部分區域的焊點開裂更嚴重,與翹曲有一定的關聯性。綜合各測試結果,推測離PCB中間區域越近的BGA錫球,越容易產生開裂。
5.原物料切片后發現部分錫球存在原始微裂紋。推測有原始微裂紋的錫球在焊接過程中,PCB板翹曲變形,使得裂紋擴張,造成錫球開裂。
·改善建議
1.管控PCB在焊接過程中的翹曲。
2.嚴格管控BGA的來料質量。

來源:Internet


