您當(dāng)前的位置:檢測(cè)資訊 > 科研開(kāi)發(fā)
嘉峪檢測(cè)網(wǎng) 2025-07-11 21:33
先對(duì)比下傳統(tǒng)正面供電和晶背供電芯片的結(jié)構(gòu)差異。顧名思義,正面供電就是將電源通過(guò)正面頂層金屬將電源輸入通過(guò)金屬過(guò)孔傳遞到晶體管;晶背供電是將電源通過(guò)背面金屬直接傳遞到晶體管或通過(guò)M1金屬層傳遞到晶體管。


背面電源分配網(wǎng)絡(luò)(Backside Power Delivery Network)是一種很巧妙的方法,它將信號(hào)層和電源層分開(kāi),更大程度地縮小晶體管的尺寸。下面是一個(gè)關(guān)于背面電源分配網(wǎng)絡(luò)(BS-PDN)如何縮小結(jié)構(gòu)尺寸的例子。


背面供電是一項(xiàng)巨大的變革。我們會(huì)把電源線移到襯底下方,這樣就能在頂部騰出更多布線空間。要知道,現(xiàn)代芯片中有數(shù)十億個(gè)相互連接的晶體管,芯片上有很多層信號(hào)互連線路。與此同時(shí),芯片頂部還有一個(gè)電源網(wǎng)格,這是一個(gè)由電源線和地線組成的網(wǎng)絡(luò),它能在半導(dǎo)體芯片上分配電力,為晶體管供電。目前,所有的互連線路和電力傳輸都來(lái)自頂部的不同金屬層。現(xiàn)在設(shè)想一下,當(dāng)我們把所有電源都移到背面時(shí),布線的復(fù)雜程度將會(huì)大大降低,我們就能更密集地布局和布線晶體管,改善擁塞狀況。

晶背供電技術(shù)的封裝設(shè)計(jì) 從美國(guó)專利:US9331062可知,整個(gè)芯片安裝在一個(gè)基板上,正面的第一套互連層通過(guò)鍵合焊盤(Wire Bond Pads) 連接到封裝基板,背面的第二套互連層則通過(guò)焊球陣列(Solder Bumps) 連接到中介層然后再連接到基板上。
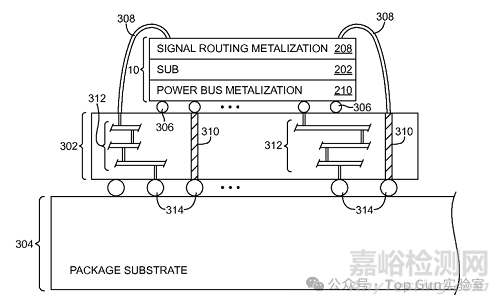
如上圖所示
1、中介層(Interposer)-302包含兩類關(guān)鍵結(jié)構(gòu):
1)硅通孔(TSV)結(jié)構(gòu)-310
垂直貫穿中介層內(nèi)部的硅核心層,提供機(jī)械支撐
材料:銅/鎢/鋁等導(dǎo)體
尺寸:直徑1~10μm,長(zhǎng)度10~100μm(與中介層厚度匹配)
功能:一端連微凸塊(Microbump-306),另一端連C4焊球-314,用于向芯片-10供電;一端連接鍵合線-308,另一端連接C4焊球-314,用于傳輸用戶數(shù)據(jù)與控制信號(hào)
2)互連布線路徑-312
由多層金屬走線和導(dǎo)電通孔構(gòu)成
相比TSV:電阻更高,但布線更靈活(支持水平/垂直多向布線)
功能:連接鍵合線-308與焊球-314,傳輸用戶信號(hào);連接微凸塊-306與焊球-314,傳輸電源信號(hào)。
2、芯片10簡(jiǎn)要圖示描述說(shuō)明(圖片來(lái)源于IMEC)


關(guān)鍵術(shù)語(yǔ)對(duì)照表
|
英文術(shù)語(yǔ) |
中文工程術(shù)語(yǔ) |
|
Interposer |
中介層 |
|
Through-Silicon Via (TSV) |
硅通孔 |
|
Microbump |
微凸塊 |
|
C4 Bump |
C4焊球 |
|
Wire Bond |
鍵合線 |
|
2.5D Stacking |
2.5D堆疊 |
|
3D Stacking |
3D堆疊 |

來(lái)源:Top Gun 實(shí)驗(yàn)室


