您當前的位置:檢測資訊 > 科研開發
嘉峪檢測網 2024-11-22 13:08
各階段常見的典型失效機理
前段制程(FEoL)常見的失效機理
1)與時間相關的電介質擊穿(TDDB)-- 柵極氧化物
2)熱載流子注入(HCI)
3)負偏壓溫度不穩定性(NBTI)
4)表面反轉(移動離子)
5)浮柵非易失性存儲器數據保持
6)局部電荷捕獲非易失性存儲器數據保持
7)相變(PCM)非易失性存儲器數據保持
后段制程(BEoL)常見的失效機理
1)與時間相關的電介質擊穿(TDDB)-- low k材質電介質/移動銅離子
2)鋁電遷移(Al EM)
3)銅電遷移(Cu EM)
4)鋁和銅腐蝕
5)鋁應力遷移(Al SM)
6)銅應力遷移(Cu SM)
封裝/界面常見的失效機理
1)因溫度循環和熱沖擊導致的疲勞失效
2)因溫度循環和熱沖擊導致的界面失效
3)因高溫導致的金屬間化合物和氧化失效
4)錫須
5)離子遷移動力學(PCB)--組件清潔度
本文對因溫度循環和熱沖擊導致的界面失效模型進行研究。
與因溫度循環和熱沖擊導致的疲勞失效模型基本一致,但主要關注于不同材料之間的界面的鏈接可靠性。
在溫度循環和溫度沖擊后,超大規模集成電路(ULSI)器件中可能會發生界面失效。界面失效可能包括:
• 爆米花效應(Popcorn Effect):通常指在特定的環境或條件下,某種物質或結構出現類似爆米花爆開的現象。在電子領域,“爆米花”現象被定義為模塑料與硅芯片、引線框架或基板之間界面分層斷裂,通常是由于界面附著力不足,尤其是在存在濕氣的狀況下,器件回流焊時很容易發生發生爆米花效應。通常使用Paris冪率模型進行建模。

• 薄膜龜裂可能發生在脆性介電薄膜中(尤其是當脆性薄膜處于靜力拉伸應力下時)。通常使用Paris冪率模型進行建模。

• 如果溫度循環導致模塑料從硅芯片表面逐漸分層,引線鍵合可能會“翹起”(引線和金屬間化合物與鍵合焊盤斷開)。如果引線的晶粒尺寸過大,在溫度循環下,引線鍵合也可能在球上方以“竹節”的方式斷裂。通常使用Coffin-Manson或Paris冪率模型進行建模。
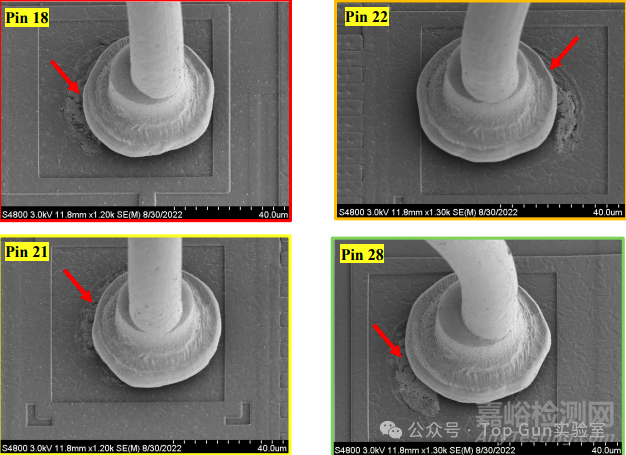
• 如果芯片邊緣附近存在焊接空洞,芯片在溫度循環或溫度沖擊時可能會發生斷裂。通常使用Coffin-Manson模型進行建模。
建模的溫變參數條件通常是所關注的范圍(即加速應力與正常使用條件),但在某些條件下,需要其他條件來進行可靠性估計(AF或FITs):
1) 溫度循環范圍跨越了一個臨界溫度,例如Tg(聚合物的玻璃化轉變溫度)。
2) 在感興趣的溫度范圍內,材料性能發生顯著變化。例如,鉛基焊料的應力松弛率在室溫附近發生了很大的變化。
Paris冪率模型:
1963年由Paris和Erdogan提出了基于斷裂力學方法的Paris冪率定律。由Paris冪率定律對裂紋擴展速率的對數與應力強度因子的對數進行建模,發現有三個區域:
a)區域I代表亞臨界裂紋萌生;
b)區域II代表緩慢裂紋生長速度;
c)區域III代表裂紋快速擴展。
Paris冪率定律用于根據冪律表征疲勞載荷下的亞臨界裂紋擴展,使用應力強度因子表示如下:

或者可選擇使用能量釋放率而不是應力強度因子:

Paris冪率定律指數m對于幾種不同的界面斷裂機制的值如下表所示:

Paris冪率模型壽命預估示例:
目標:
計算日常使用環境中模塑料從硅芯片(低k或FTEOS與 Cu)分層的加速因子(AF),并與汽車環境中的進行比較。
假設條件:
1)日常使用環境條件為:每日溫度波動20°C一次
2)汽車環境條件為:每天4個循環,溫度波動80°C
3)遵循使用能量釋放率的Paris冪率定律:dN∝(ΔG)–m
4)m=4
AF計算公式:
AF=(ΔGoffice/(ΔGauto)–m
假設條件代入計算:
AF=(20/80)–4=256/循環,但汽車環境精力的溫循更多
結論:對汽車環境與日常使用環境進行比較評估,會發現日常使用環境故障前時間(TTF)值是汽車環境的1000倍,其中256倍是由于溫度差的差異,4倍是由于循環頻率。

來源:Top Gun實驗室


