您當前的位置:檢測資訊 > 科研開發
嘉峪檢測網 2025-09-28 18:58
導語:在現代電子設備中,存儲單元扮演著至關重要的角色,從手機消費品、工業設備、汽車電子、醫療設備、幾乎都有一顆甚至多顆“記憶體”。然而,這些設備產品中的存儲單元(Flash、SRAM、DRAM、ROM等)可能會發生”無緣無故”的失效。特別是對于戶外高海拔裝置、航天控制系統,輻射對其影響不容忽視。本文將探討輻射對存儲器件的失效影響,分析其機理,并提出相應的改進措施。
一、輻射類型
要理解輻射對存儲器件的影響,首先需明確輻射的核心分類標準—— 根據能量是否能使物質原子發生電離,輻射可分為兩大類,且只有特定類型的輻射會導致存儲器件失效。
1.1 電離輻射(存儲失效的 “主因”)
定義:能量高于物質原子電離能(通常>10eV),能使原子中的核外電子脫離原子核束縛,形成帶電離子的輻射。
常見類型:γ 射線、X 射線、高能電子(β 射線)、中子、重離子(如質子、氦離子)等。
關鍵特性:能量高、穿透力強,既能改變存儲器件的電子態(如產生電荷積累),也能破壞原子排列(如導致晶格移位),是引發存儲器件失效的核心輻射類型。
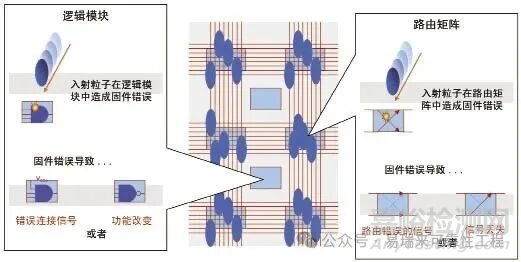
圖1 輻射引發SRAM FPGA失效
1.2 非電離輻射(無存儲失效風險)
定義:能量低于物質原子電離能,無法使原子電離,僅能引發原子振動加劇或電子能級躍遷(電子不脫離原子核)的輻射。
常見類型:射頻、紅外線、可見光、微波等。
關鍵特性:能量低、作用溫和,既無法在存儲器件中產生電離電荷,也不能將晶格原子“撞出原位”,因此幾乎不會導致存儲器件和其它器件的輻射失效。
二、電離輻射引發的存儲失效機理:三類核心“傷害路徑”
電離輻射對存儲器件的失效影響,通過三種獨立且明確的機理實現—— 總電離劑量效應(TID)、位移效應(DD)、單粒子效應(SEE)。這三類機理均由電離輻射引發,但作用方式、影響特點完全不同,逐一說明如下:
2.1 總電離劑量效應(TID):“累積的電荷傷害”
2.1.1 定義與機理
總電離劑量(Total Ionizing Dose,TID):指電離輻射在存儲器件材料(如硅、氧化層)中產生的“總電離電荷密度”,單位通常為 krad (Si)(每克硅吸收輻射能量對應的電離電荷)。
失效機理:電離輻射(如γ 射線、X 射線)照射時,會在器件的 “氧化層”(如 MOS 管柵氧化層、存儲電容介質層)中產生大量 “電子 - 空穴對”。其中,電子遷移速度快,會迅速被電極收集;但空穴遷移慢,易被氧化層缺陷 “困住”(形成 “氧化層陷阱電荷”),或在氧化層與硅襯底界面形成 “界面態”。隨著輻射劑量累積,這些電荷和界面態會形成 “寄生電場”,改變器件電學特性。
2.1.2 對不同存儲器的失效影響
|
存儲器類型 |
TID 導致的典型失效 |
核心影響機理 |
|
DRAM(動態隨機存取存儲器) |
刷新周期縮短、數據保持時間變短、漏電流增大 |
柵氧化層陷阱電荷使MOS 管閾值電壓降低,存儲電容電荷泄漏加速,需更頻繁刷新才能保住數據 |
|
NAND Flash(閃存) |
編程/ 擦除(P/E)次數減少、閾值電壓窗口縮小、數據保存時間下降 |
隧道氧化層陷阱電荷阻礙電子隧道注入/ 抽出,導致編程失敗;界面態加劇漏電,縮短數據 retention 時間 |
|
SRAM(靜態隨機存取存儲器) |
靜態功耗上升、讀寫錯誤率增加、閂鎖效應風險提高 |
界面態惡化MOS 管亞閾值特性,產生額外漏電;閾值電壓偏移導致存儲單元無法穩定保持 “0/1” |
|
ROM(只讀存儲器) |
輸出電平漂移、部分存儲位“翻轉” |
氧化層累積電荷改變器件導通特性,高電平位可能因漏電變為低電平 |
2.1.3 關鍵特點
累積性:即使單次輻射劑量低,長期照射后總劑量達到閾值(商用器件通常10-100 krad (Si),航天級需>1000 krad (Si)),仍會導致永久失效;
普遍性:所有依賴氧化層/ 介質層的存儲器均受影響,無 “豁免類型”。
2.2 位移效應(DD):“晶格缺陷的破壞”
2.2.1 定義與機理
位移效應(Displacement Damage):指電離輻射中的“高能粒子”(如中子、重離子)撞擊存儲器件半導體晶格,使晶格原子脫離原位置,形成 “空位 - 間隙原子對”(弗倫克爾缺陷)的失效機理。
失效邏輯:高能粒子的動量傳遞給晶格原子,使其獲得足夠能量“跳出” 平衡位置 —— 空位(原子離開后的空缺)和間隙原子(脫離原位的原子)會成為 “載流子障礙”:要么阻礙電子 / 空穴運動,降低載流子遷移率;要么改變存儲單元的電荷存儲能力,最終破壞 “0/1” 數據狀態。
2.2.2 對不同存儲器的失效影響
|
存儲器類型 |
DD導致的典型失效 |
核心影響機理 |
|
DRAM |
存儲電容漏電加劇、刷新失敗 |
晶格缺陷使電容介質層出現“漏電通道”,電荷無法穩定保存 |
|
SRAM |
靜態電流激增、邏輯狀態翻轉 |
缺陷作為載流子復合中心,導致MOS 管導通特性異常,存儲單元無法保持穩定狀態 |
|
可編程存儲器件(如EEPROM) |
編程電壓閾值升高、擦除不完全 |
晶格缺陷阻礙電荷在浮柵與襯底間的轉移,導致編程/ 擦除操作失效 |
2.2.3 關鍵特點
瞬時性:單次高能粒子撞擊即可產生缺陷,無需劑量累積;
針對性:對晶格結構敏感的存儲器(如DRAM、SRAM)影響更顯著,對無晶格依賴的器件(如部分新型閃存)影響較弱。
2.3 單粒子效應(SEE):“單個粒子的精準打擊”
2.3.1 定義與機理
單粒子效應(Single Event Effect,SEE):指電離輻射中“單個高能粒子”(如重離子、質子)穿過存儲器件時,在局部區域產生大量電子 - 空穴對,引發器件邏輯狀態異常或功能失效的機理。
失效邏輯:單個高能粒子(能量通常>MeV)在器件中形成 “電荷軌跡”,局部電荷密度極高 —— 若這些電荷被存儲單元(如 SRAM 的觸發器、DRAM 的電容)收集,會瞬間改變單元的電荷平衡:例如 SRAM 中觸發器的 “0” 狀態被瞬間 “沖翻” 為 “1”,DRAM 電容中的電荷被瞬間中和,導致數據錯誤。
2.3.2 SEE 的主要類型及對存儲器的影響
SEE 并非單一失效模式,根據影響程度可分為 “軟失效”(可恢復)和 “硬失效”(永久損壞):
|
SEE 類型 |
定義 |
對存儲器的影響 |
恢復情況 |
|
單粒子翻轉(SEU) |
單個粒子導致存儲單元數據“0→1” 或 “1→0” |
DRAM/SRAM 數據錯誤、Flash 編程位錯誤 |
重新寫入正確數據即可恢復(軟失效) |
|
單粒子鎖定(SEL) |
粒子引發器件內部形成低阻通路,電流激增 |
存儲芯片過熱、燒毀,甚至牽連整個電路 |
需斷電重啟,嚴重時導致永久損壞(半硬失效) |
|
單粒子燒毀(SEB) |
粒子導致功率器件(如存儲芯片的供電管)擊穿 |
存儲芯片供電電路損壞,無法供電 |
永久失效,需更換器件 |
|
單粒子擦除(SEE) |
粒子導致Flash 浮柵上的電荷瞬間丟失 |
存儲數據被意外擦除 |
重新編程可恢復數據,但器件無損壞(軟失效) |
2.3.3 關鍵特點
隨機性:粒子撞擊位置、時間不可預測,失效具有偶發性;
高風險場景:航天(宇宙射線中的重離子)、核工業(輻射源附近)等場景中,SEE 發生概率顯著升高。

三、存儲器件抗輻射失效的措施:多層級防護體系
針對上述三類失效機理,從“器件設計 - 制造工藝 - 系統應用” 三個層面構建防護體系,覆蓋不同輻射場景需求:
3.1 器件設計:從 “源頭” 提升抗輻射能力
3.1.1 針對 TID 的設計優化
氧化層加固:采用“高純度氧化層制備工藝”(如原子層沉積 ALD),減少氧化層中的初始缺陷,降低陷阱電荷產生概率;
界面態抑制:在氧化層與硅襯底間引入“氮化物緩沖層”,減少輻射引發的界面態生成。
3.1.2 針對位移效應的設計優化
晶格結構強化:采用“應變硅技術”,通過應力增強晶格原子間的結合力,減少粒子撞擊導致的原子移位;
冗余晶格設計:在存儲單元周圍設置“備用晶格區域”,即使部分晶格出現缺陷,也可通過電路切換啟用備用區域。
3.1.3 針對 SEE 的設計優化
抗SEU 存儲單元:SRAM 采用 “雙互鎖存儲單元(DICE)”,通過 4 個晶體管形成交叉反饋結構,單個粒子撞擊無法改變狀態;DRAM 增加 “電荷冗余電容”,提高抗電荷擾動能力;
SEL 防護電路:在存儲芯片供電端串聯“電流限制器”,一旦發生 SEL 導致電流激增,立即切斷供電,避免器件燒毀。
3.2 制造工藝:減少 “先天缺陷”
抗輻射材料選用:采用“高純度硅片”(雜質含量<10¹? atoms/cm³),減少輻射引發缺陷的 “靶點”;Flash 的隧道氧化層采用 “多層氧化 - 氮化 - 氧化(ONO)結構”,提升抗電荷陷阱能力;
工藝參數優化:離子注入過程中控制“低能量、低劑量”,減少注入對晶格的損傷;退火工藝采用 “快速熱退火(RTA)”,消除制造過程中產生的初始晶格缺陷。
3.3 系統應用:“后天補救” 降低失效影響
3.3.1 軟件層面
錯誤檢測與糾正(EDAC):在存儲系統中集成“漢明碼”“BCH 碼” 等糾錯電路,實時檢測 SEU 導致的數據錯誤并自動糾正;對重要數據采用 “三重校驗碼”,提升糾錯能力;
定期數據刷新:針對TID 導致的 DRAM 數據保持時間縮短,通過軟件設置 “動態刷新周期”,根據輻射環境強度調整刷新頻率。
3.3.2 硬件層面
輻射屏蔽:在存儲器件外部設置“重金屬屏蔽層”(如鉛、鎢合金),削弱 γ 射線、X 射線的穿透力;航天場景中采用 “多層屏蔽結構”(鋁 + 聚乙烯),同時屏蔽重離子和中子;
冗余設計:采用“三模冗余(TMR)”—— 三個相同存儲模塊同時存儲數據,通過 “多數表決” 輸出正確結果,即使一個模塊因 SEE 失效,也不影響系統運行;重要數據采用 “冷熱備份”,主存儲失效時立即切換至備份存儲。
結語:隨著技術的發展,新型存儲器如MRAM、RRAM和FRAM展現出比傳統SRAM和DRAM更好的抗輻射特性,在航空航天和核工業等輻射環境中具有廣闊應用前景。

來源:易瑞來可靠性工程


