您當前的位置:檢測資訊 > 檢測案例
嘉峪檢測網 2024-08-21 09:04
硅基低壓MOSFET器件因其在多個高科技領域的應用而成為研究的焦點,尤其是在小電流驅動和電源控制模塊等方面。這些器件的性能和可靠性很大程度上依賴于生產過程中的工藝質量。本文通過采用熱點分析和聚焦離子束-掃描電子顯微鏡(FIB-SEM)技術,提出了一種高效的檢測手段,用以快速識別和分析溝槽MOSFET器件在電學性能和膜層結構上的失效。下圖是晶圓失效分析流程概述圖。

硅基低壓MOSFET的市場背景和重要性,然后詳細介紹了器件的制造工藝,包括關鍵步驟如外延片的選用、低壓化學氣相沉積(LPCVD)、光刻、刻蝕、多晶硅層的沉積以及金屬化過程。在失效分析方面,結合了I-V特性測試、電光微區掃描(EMMI)熱點檢測和FIB-SEM結構分析等技術手段,以識別和診斷器件失效的原因。

器件溝槽形貌異常剖面圖
在對溝槽型MOSFET產品的實際測試中,觀察到最小擊穿電壓達到60V,并利用I-V測試和EMMI技術精確定位了漏電失效點。FIB-SEM的形貌分析進一步揭示了溝槽結構的不均勻性,包括多晶硅層的不均勻分布和上部區域的凹槽現象。文章深入探討了可能的工藝問題,指出了LPCVD多晶硅沉積過程中的異常、過量刻蝕的選擇性和速率差異可能是導致失效的關鍵因素。
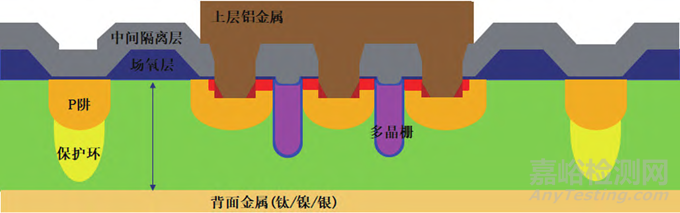
此結論強調了EMMI和FIB-SEM檢測方法在快速診斷MOSFET器件多晶硅刻蝕異常方面的重要性,并為量產過程中的漏電失效問題提供了解決方案。此外,提出了在中試和量產階段增加設備維護的建議,以提高工藝的穩定性和產品的可靠性。金鑒具備Dual Beam FIB-SEM業務,包括透射電鏡( TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等,方便大家對材料進行深入的失效分析及研究。
總的來說,通過結合工藝流程和失效分析技術,為硅基低壓MOSFET器件的失效分析和工藝改進提供了全面的技術支持和策略,有助于推動相關領域的技術進步和產品質量的提升。

來源:Internet


