首先,不常耍TEM的小伙伴最經(jīng)常犯的錯(cuò)誤之一就是:把TEM當(dāng)成單純的放大鏡而忽視了TEM獲取的信息是三維的����。
我舉個(gè)例子:
曾經(jīng)有個(gè)小伙伴寫的論文�,通過TEM圖像統(tǒng)計(jì)����,在樣品A中析出相密度只有樣品B中的70%,他認(rèn)為這是導(dǎo)致材料性能不同的重要原因����。但是卻在論文審稿時(shí)被一棍子打死......
Why�?
TEM��、STEM與SEM最大的區(qū)別在于TEM獲取信息時(shí)電子束要穿透樣品�����,因此樣品厚度必須要考慮。上面那個(gè)例子中,如果樣品A的觀測(cè)區(qū)域厚度是70nm而樣品B是100nm��,那么二者的析出相密度實(shí)質(zhì)上是沒有區(qū)別的......
因此���,在TEM實(shí)驗(yàn)中����,樣品觀測(cè)區(qū)厚度是非常重要的�。
那么一個(gè)問題就來了:怎么測(cè)量觀測(cè)區(qū)的厚度呢?
等厚條紋法
等厚條紋法是最常用的方法��,原因是不需要電鏡安裝其他硬件�,也不需要調(diào)整太多的參數(shù),只要一個(gè)雙傾臺(tái)就能做�,而雙傾臺(tái)是TEM必備的����。
使用等厚條紋法測(cè)量TEM樣品厚度時(shí)只需要進(jìn)入雙束模式(此時(shí)電子衍射譜中僅保留透射電子束和另一束較強(qiáng)的衍射束�����,關(guān)于TEM雙束的一些操作和數(shù)據(jù)分析我會(huì)在后續(xù)的文章中提到��。如果不要求親自操作的話,只要給操作員提要求就行����,他們會(huì)操作的����。)
在雙束模式下����,TEM入射電子的能量可以近似認(rèn)為由透射束和最強(qiáng)的衍射束組成。在雙束條件下樣品的襯度會(huì)隨厚度增大呈現(xiàn)周期性的明暗變化���,稱為等厚條紋。條紋變化的周期與厚度相關(guān)�����,一個(gè)周期對(duì)應(yīng)的厚度稱為消光距離 ξg �����。
由于衍射束和透射束是互補(bǔ)的,因此在TEM明場(chǎng)像和暗場(chǎng)像中都能觀察到等厚條紋,而且二者的襯度是相反的����。在明場(chǎng)像中:樣品厚度滿足 t=(n−12)ξg 時(shí)透射束強(qiáng)度最低����,表現(xiàn)為暗紋����,在 t=nξg 時(shí)則是亮紋���。在暗場(chǎng)像中襯度相反�。(n為整數(shù)�,從1開始取)
顯然�����,只要我們找到第一條暗紋(亮紋)就能通過條紋的數(shù)量來估測(cè)厚度���。當(dāng)然�����,這里不可避免的要討論 ξg 。我直接給結(jié)果把:
這里: Ω 為單個(gè)晶胞的體積; λ 為電子波長(zhǎng)��;f(θ) 是原子的電子散射因子����; θ 為對(duì)應(yīng)晶面的布拉格衍射角。電子散射因子可以在國際X射線晶體學(xué)手冊(cè)中查詢���。注意,這個(gè)方法存在一個(gè)弊端�,那就是n=1的條紋一定要找準(zhǔn)����!在有些樣品中如果最薄的區(qū)域厚度也大于 ξg 會(huì)導(dǎo)致丟失第一級(jí)條紋����,因此需要操作者有一定經(jīng)驗(yàn)。
下圖是一個(gè)典型的等厚條紋測(cè)量結(jié)果
污染點(diǎn)分離法
污染點(diǎn)分離法其實(shí)就是簡(jiǎn)單的幾何法,大體的意思就是如果TEM樣品的上下表面各有一個(gè)污染點(diǎn),通過調(diào)整樣品傾斜角度讓二者重合���,然后再轉(zhuǎn)到二者分離,依靠測(cè)量轉(zhuǎn)過的角度以幾何方法計(jì)算樣品厚度。原理如下:
這個(gè)方法有多種變種���,比如使用貫穿樣品山下表明的晶界作為標(biāo)記物,或者在一些原子序數(shù)較低的樣品中通過匯聚電子束在樣品中人為制造一個(gè)貫穿樣品的污染點(diǎn),然后再測(cè)量。
雖然該方法原理超級(jí)簡(jiǎn)單......但實(shí)際上采用這一方式的并不多......
匯聚束電子衍射法
匯聚束電子衍射(CBED)是一個(gè)被很多人認(rèn)為是高大上的手法(CBED衍射有機(jī)會(huì)我們后面講吧)���,這個(gè)方法是通過標(biāo)定雙束條件下CBED中(hkl)衍射盤中明暗條紋的布拉格角差異,計(jì)算出每個(gè)條紋的偏移矢量 Δθi :
其中θ為hkl晶面的布拉格衍射角,d為hkl晶面的面間距����,λ是電子波長(zhǎng)�����。
誒?我們算這玩意干啥�����?
別急啊�,我們算這玩意是因?yàn)?si 與消光距離 ξg 以及樣品厚度t之間存在數(shù)學(xué)關(guān)系:
看到(3)是不是就想到如果用 si2n2 和 1n2 做擬合����,那么直線的斜率和消光距離有關(guān)、截距就和厚度有關(guān)了�,就像下圖那樣����。
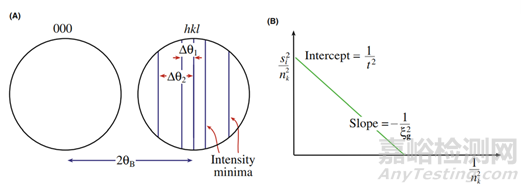
這個(gè)方法有個(gè)好處�,就是理論上他不需要事先知道 ξg ,而可以避免錯(cuò)過n=1條紋導(dǎo)致的問題(n判斷錯(cuò)誤的話擬合不是直線)�。
但是����!這個(gè)方法也有問題���!這點(diǎn)一定要講清楚�。
CBED衍射操作起來不如普通電子衍射那么簡(jiǎn)單,很多操作員是不會(huì)做的......而CBED時(shí)衍射強(qiáng)度相當(dāng)高(因?yàn)槭菚?huì)聚光)�����,一些較老的CCD在捕獲CBED時(shí)可能會(huì)有危險(xiǎn)(別問我咋知道的)。
聚焦離子束法
聚焦離子束(FIB)是一個(gè)非常簡(jiǎn)單暴力的方法�,用離子刀切出來TEM樣品后直接在高分辨SEM中拍張照���,測(cè)量一下就能知道大致厚度�。
使用聚焦離子束系統(tǒng)制備的鋼鐵TEM樣品���,可以大致測(cè)量厚度
能量損失譜法
另一種高大上的方法.......
簡(jiǎn)單來說���,通過計(jì)算能量損失譜(EELS)中零損失峰的積分強(qiáng)度和損失譜總積分強(qiáng)度可以“簡(jiǎn)單”的計(jì)算出樣品厚度:
其中 It 是損失普的總積分強(qiáng)度��, I0 是零損失峰的積分強(qiáng)度, λ 是為非彈性事件發(fā)生的平均自由程��, λ 可以計(jì)算也可以通過其他手段測(cè)量(詳細(xì)請(qǐng)看David B. Williams和C. Barry Carter的神作Transmission Electron Microscopy A Textbook for Materials Science)��。下圖是一個(gè)能量損失普的示意圖�����。
這個(gè)方法操作起來要簡(jiǎn)單的多,而且可靠性也相當(dāng)高����。但是......他的問題在于你要找到一個(gè)帶有良好狀態(tài)EELS的TEM��,并且能承受它的價(jià)格......
另外補(bǔ)充一點(diǎn),除了FIB外��,測(cè)量TEM樣品厚度其實(shí)指的是測(cè)量觀測(cè)區(qū)域的厚度���,因?yàn)門EM樣品本身厚度變化很大���。所以不存在今天拍照明天再去側(cè)厚度的說法��,或者說��,厚度測(cè)量是不能補(bǔ)的數(shù)據(jù),必須在做實(shí)驗(yàn)時(shí)同步測(cè)量����。
還有����,TEM測(cè)量樣品厚度不可能非常精確��,一般認(rèn)為誤差不低于10%��。