您當(dāng)前的位置:檢測(cè)資訊 > 科研開(kāi)發(fā)
嘉峪檢測(cè)網(wǎng) 2022-03-14 23:14
長(zhǎng)江存儲(chǔ)的XtackingTM是一種新型3D(三維)NAND 閃存架構(gòu),其中存儲(chǔ)單元和外圍電路由數(shù)百萬(wàn)對(duì)小間距金屬通孔進(jìn)行互聯(lián)。因此,其鍵合界面的可靠性引起了人們極大的興趣。長(zhǎng)江存儲(chǔ)的Yan Ouyang等人,對(duì)XtackingTM鍵合界面進(jìn)行了可靠性測(cè)試驗(yàn)證。結(jié)果表明,經(jīng)過(guò)超長(zhǎng)時(shí)間的熱應(yīng)力及濕熱應(yīng)力(如7000小時(shí))后,鍵合界面表現(xiàn)出了穩(wěn)定的電性能和良好的粘結(jié)強(qiáng)度,遠(yuǎn)高于行業(yè)的一般要求(如1000小時(shí))。此外,在長(zhǎng)時(shí)間溫度循環(huán)試驗(yàn)后的拉力測(cè)試也進(jìn)一步證明了鍵合界面具有良好的強(qiáng)度和電氣穩(wěn)定性。
XtackingTM架構(gòu)的存儲(chǔ)單元和外圍電路分別是在兩個(gè)不同的晶圓(晶圓A和B)上制造,然后通過(guò)數(shù)百萬(wàn)對(duì)小間距金屬通孔互聯(lián)。與傳統(tǒng)的3D NAND架構(gòu)相比,XtackingTM架構(gòu)不僅提高了存儲(chǔ)密度,還實(shí)現(xiàn)了更高的I/O傳輸速度。

XtackingTM鍵合工藝的結(jié)構(gòu)示意圖
在形成A芯片和B芯片的BEOL layer后,通過(guò)電鍍和化學(xué)機(jī)械拋光獲得鍵合通孔,然后通過(guò)等離子體清洗、芯片之間對(duì)準(zhǔn)和退火,這樣就可以形成間距約為1μm的鍵合界面。
鍵合過(guò)程是XtackingTM體系架構(gòu)中最關(guān)鍵的一步。在鍵合過(guò)程中,數(shù)百萬(wàn)對(duì)小間距的金屬通孔要實(shí)現(xiàn)電氣互聯(lián)和保持一定的機(jī)械強(qiáng)度。研究人員采用了四種典型鍵合界面結(jié)構(gòu),通過(guò)監(jiān)測(cè)超長(zhǎng)時(shí)間熱應(yīng)力或濕熱應(yīng)力下的電阻變化和漏電流,探索了XtackingTM體系架構(gòu)鍵合界面的可靠性。
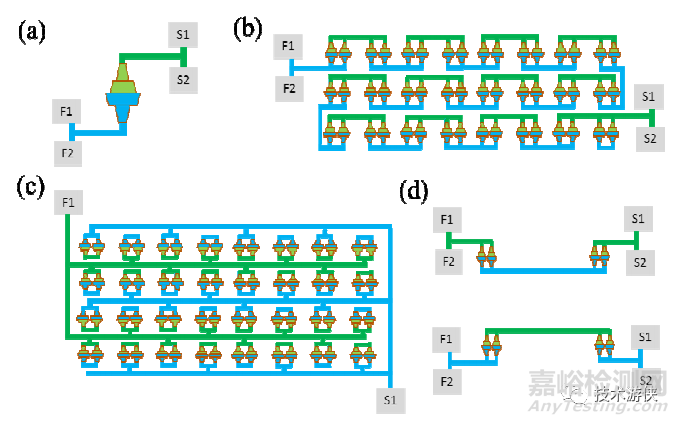
驗(yàn)證鍵合界面可靠性的試驗(yàn)包括溫度循環(huán)(TC)、高溫貯存(HTS)和穩(wěn)態(tài)濕熱(THS),截止條件是電阻值和漏電流超過(guò)規(guī)定值。從試驗(yàn)條件來(lái)看,試驗(yàn)強(qiáng)度還是比較大的,遠(yuǎn)超產(chǎn)品級(jí)的試驗(yàn)條件,THS為7000h、溫循為15000次循環(huán)、高溫貯存為200℃,7000h。

試驗(yàn)結(jié)果
(1)溫循應(yīng)力后的變化:a結(jié)構(gòu)和b結(jié)構(gòu)在溫循168次、2500次、15000次的阻值變化,以及(c1)在(c2)在15000次后的漏電曲線分布。

(2)高溫應(yīng)力后的變化:a結(jié)構(gòu)和b結(jié)構(gòu)在高溫貯存168小時(shí)、1000小時(shí)、7000小時(shí)的阻值變化,以及(c1)在(c2)在7000小時(shí)的漏電曲線分布。

(3)穩(wěn)態(tài)濕熱應(yīng)力后的變化:a結(jié)構(gòu)和b結(jié)構(gòu)在穩(wěn)態(tài)濕熱168小時(shí)、2500小時(shí)、15000小時(shí)的阻值變化,以及(c1)在(c2)在7000小時(shí)的漏電曲線分布。

三種可靠性試驗(yàn)后的測(cè)試結(jié)果顯示,鍵合結(jié)構(gòu)在經(jīng)過(guò)超長(zhǎng)時(shí)間的溫循應(yīng)力、濕熱應(yīng)力以及高溫應(yīng)力后沒(méi)有發(fā)現(xiàn)明顯的電阻值漂移及漏電。

另外,為了進(jìn)一步分析電阻漂移在三種應(yīng)力下的變化趨勢(shì):在穩(wěn)態(tài)濕熱試驗(yàn)中變化較小,而在溫循和高溫應(yīng)力下是降低,其中高溫應(yīng)力更為明顯,這是由于退火工藝的原因。

在三種應(yīng)力后,鍵合界面沒(méi)有出現(xiàn)明顯裂紋,同時(shí)電氣性能也非常穩(wěn)定,這也反映了XtackingTM鍵合界面良好的可靠性。

由于溫循應(yīng)力對(duì)于可靠性更為敏感,因此進(jìn)一步驗(yàn)證了鍵合界面在經(jīng)歷溫循后的可靠性。對(duì)鍵合結(jié)構(gòu)施加相對(duì)拉力并觀察斷裂界面形貌,發(fā)現(xiàn)鍵合粘接界面的斷裂比例在5%以內(nèi),非常小。結(jié)果表明,鍵合界面不是 XtackingTM中最薄弱的層架構(gòu),即使經(jīng)過(guò)超長(zhǎng)時(shí)間溫循應(yīng)力后也不會(huì)降低鍵合界面強(qiáng)度。

同時(shí),還分析了溫循應(yīng)力對(duì)鍵合通孔附近金屬內(nèi)電介質(zhì)性能的影響。結(jié)果顯示,在15000次溫循后樣品的電壓-電流曲線與沒(méi)有經(jīng)歷溫循應(yīng)力的樣品沒(méi)有明顯變化,這意味著在超長(zhǎng)時(shí)間溫循應(yīng)力后沒(méi)有更多的銅擴(kuò)散到鍵合層電介質(zhì)或沒(méi)有損傷,這結(jié)果進(jìn)一步證明了XtackingTM良好的可靠性。
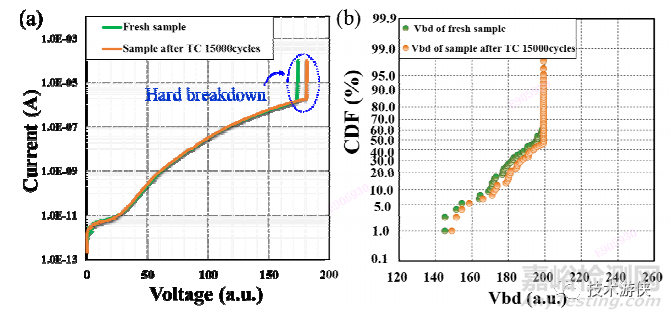

來(lái)源:技術(shù)游俠


