您當前的位置:檢測資訊 > 科研開發
嘉峪檢測網 2024-09-02 14:50
材料科學領域的應用
隨著納米技術的發展,對材料微觀結構的精確加工需求日益增長。聚焦離子束(FIB)結合掃描電子顯微鏡(SEM)的雙束系統,以其在微觀尺度上的高精度加工和實時觀察能力,成為納米器件制造和納米結構加工的關鍵技術。FIB技術在微納米加工、集成電路修復和材料科學研究等多個領域發揮著重要作用。
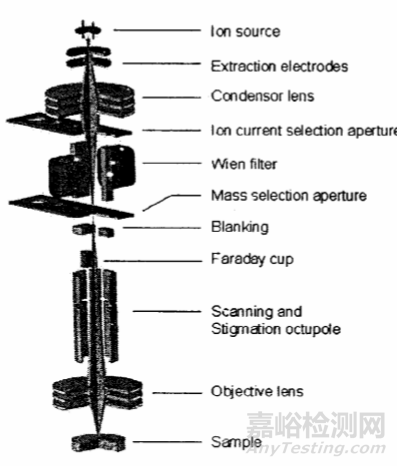
圖1 聚焦離子束掃描電鏡中離子束系統結構示意圖
FIB雙束系統的組成與原理
FIB雙束系統由離子源、靜電透鏡、偏轉裝置等組成,如圖1所示。系統利用強電場從液態金屬離子源(如鎵)中抽取離子,通過透鏡和光闌聚焦成束,作用于樣品以實現刻蝕或切割。同時,二次電子和二次離子的收集可用于生成顯微圖像。樣品室配備可調樣品臺,以實現多角度分析和加工。
FIB雙束系統在材料研究中的應用
1.離子束精密刻蝕加工
FIB刻蝕技術包括物理刻蝕和反應刻蝕兩種方式。高能離子束與樣品相互作用,通過濺射實現材料的微區去除。此外,利用特定氣體與樣品的化學反應,可進行選擇性或增強型刻蝕,提高材料加工的選擇性和側壁垂直度。
2.樣品剖面觀察
傳統剖面制備方法在特定或微小區域觀察時存在局限。FIB雙束系統通過SEM定位和離子束刻蝕,可快速準確地加工出清晰的材料斷面。
3.透射電鏡樣品制備
FIB雙束系統可制備厚度在100nm以下的透射電鏡樣品。通過離子束或電子束沉積保護層,切割出薄片,使用微操作機械手提取并粘結在銅網上,最終減薄至所需厚度。
為方便客戶對材料進行深入的失效分析及研究,金鑒實驗室具備Dual Beam FIB-SEM業務,并介紹Dual Beam FIB-SEM在材料科學領域的一些典型應用,包括透射電鏡( TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等。
FIB的其他應用
FIB不僅可用于樣品表面成像,還能反映材料表層的詳細信息。此外,FIB的刻蝕和沉積功能在半導體集成電路修復和電子束曝光等領域也有應用。

來源:Internet


